FIB Probenvorbereitung
Im Gegensatz zu den zeitaufwändigen, konventionellen TEM-Probenpräparationsmethoden ermöglicht das Sputtern mit fokussierten Ionenstrahlen (FIB) in einem Zweistrahl-REM-System die (halb-)automatisierte und wesentlich schnellere Herstellung hochwertiger Proben für verschiedene TEM-Untersuchungen (innerhalb weniger Stunden). Moderne Zweistrahl-FIB/SEM-Systeme verwenden präzise, piezogesteuerte Manipulatoren, verschiedene Gasinjektionssysteme zum Schutz der Probenoberfläche, energiedispersive Röntgenspektroskopie zur Messung der Zusammensetzung und verschiedene Detektoren zur Abbildung der Probe während des Präparationsprozesses. Bei den dualen Systemen erfolgt der Abbildungsprozess mit Hilfe von Rasterelektronen (REM), wobei das Scannen von fokussierten Galliumionen an der Probenoberfläche einen lokalen Materialabtrag ermöglicht.
Helios Nanolab FIB
Das Standardverfahren für die TEM-Lamellenpräparation (Lift-Out-Methode) besteht aus dem Aufbringen einer Schutzschicht (z. B. Pt, C, W), dem Schneiden der Scheibe senkrecht zur Oberfläche (Querschnittspräparation), dem Herausheben der Scheibe mit Hilfe eines Mikromanipulators, dem Anbringen der Probe auf einem TEM-Trägergitter aus Cu oder Mo und schließlich dem Polieren der Lamelle auf die gewünschten Abmessungen und Dicken. Durch Variationen der Beschleunigungsspannung (typischerweise 5 - 30 keV) und des Strahlstroms (2,8 nA - 48 pA) sind die FIB/SEM-Systeme in der Lage, ultradünne TEM-Proben aus fast allen Materialien in fester Form zu präparieren - von Metallen bis zu weicher Materie.
Am ER-C arbeiten wir mit einem Helios NanoLab 400S und einem Helios NanoLab 460F1.
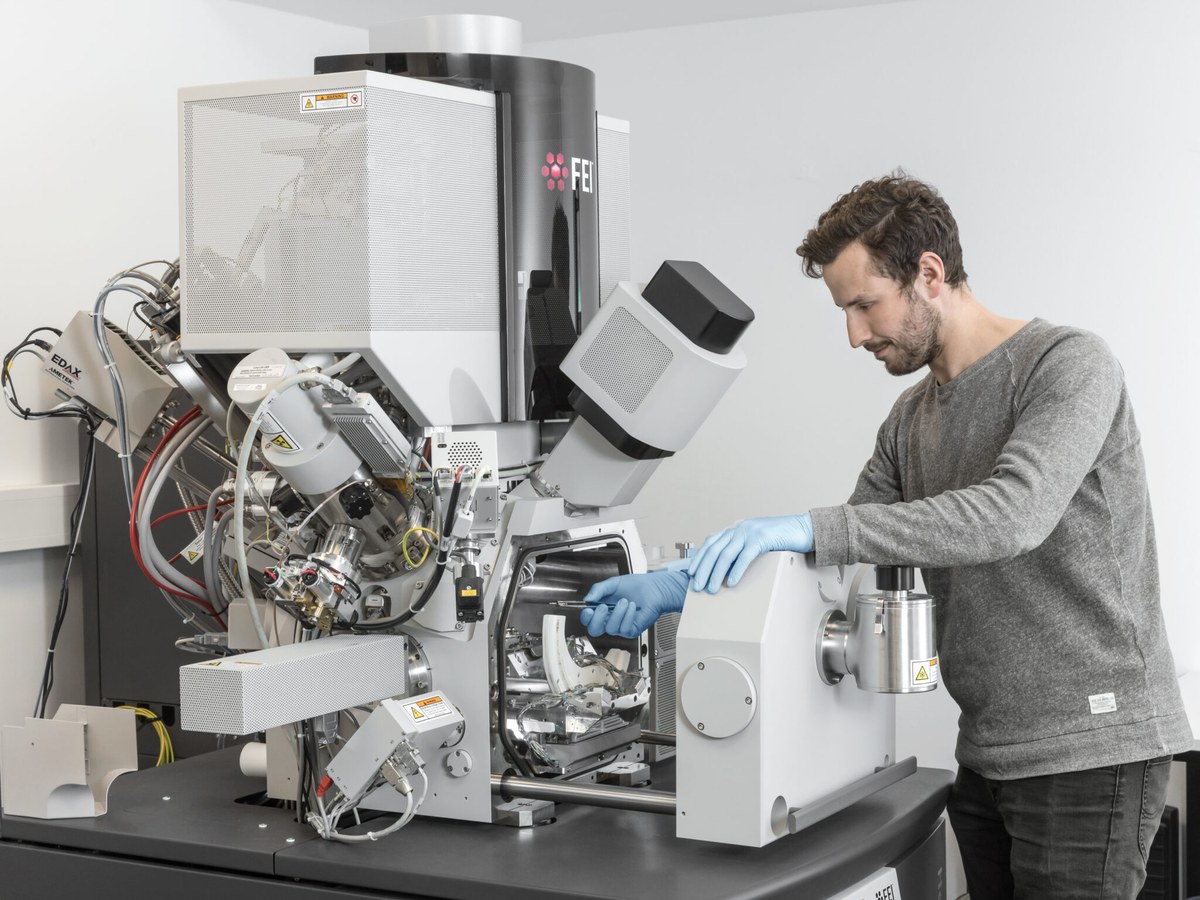
Fischione Nanomill®
Die Fischione Nanomill® ist ein niederenergetisches, fokussiertes Ar-Ionen-Frässystem (<1 keV), das für die Entfernung der FIB-induzierten Schadensschicht von TEM-Lamellen eingesetzt wird. Der scannende Ionenstrahl liefert Bilder auf der Basis von Sekundärelektronen, die dazu beitragen, den Sputterprozess ausschließlich auf die von der FIB vorbereitete Lamelle zu konzentrieren. Das System ist mit einer Flüssigstickstoffkühlung für das Sputtern empfindlicher Materialien ausgestattet. Die Parameter des Ionenfräsverfahrens können individuell an das Probenmaterial und das Ziel des TEM-Experiments angepasst werden.
Referenz: doi:10.1017/S1431927617000514

